持续改进
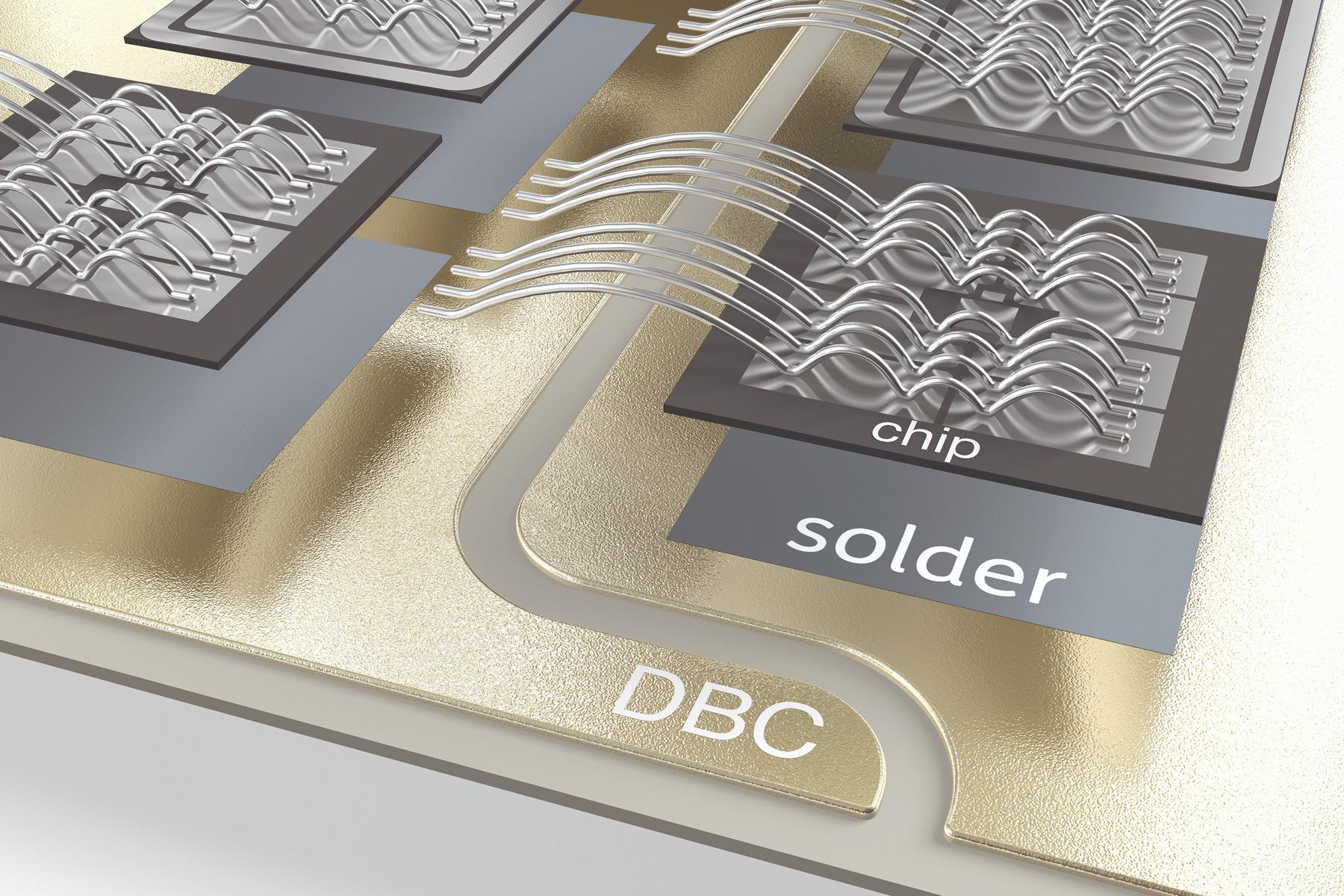
焊料长期以来一直在芯片背面和基板以及端子和基板之间提供可靠的键合。用模板将焊料施加到 DBC 基板上,与 PCB 元件填充的方式大致相同。专用温箱熔化焊料,形成与芯片的键合。由于这些温箱和生产工艺的改进,在每年生产的数百万个模块中展示了无空洞的焊料连接。
对于芯片正面连接,铝制键合引线通过超声波焊接到芯片表面的铝层上。对功率循环疲劳机制的持续研究帮助实现引线直径和键合引线纵横比的优化。这些改进进一步提高了标准连接技术的可靠性。赛米控丹佛斯还使用铝包铜键合引线。这些引线具有铜的更高功率循环能力,同时保持了铝键合引线的经济高效的生产工艺。
