継続的な改善
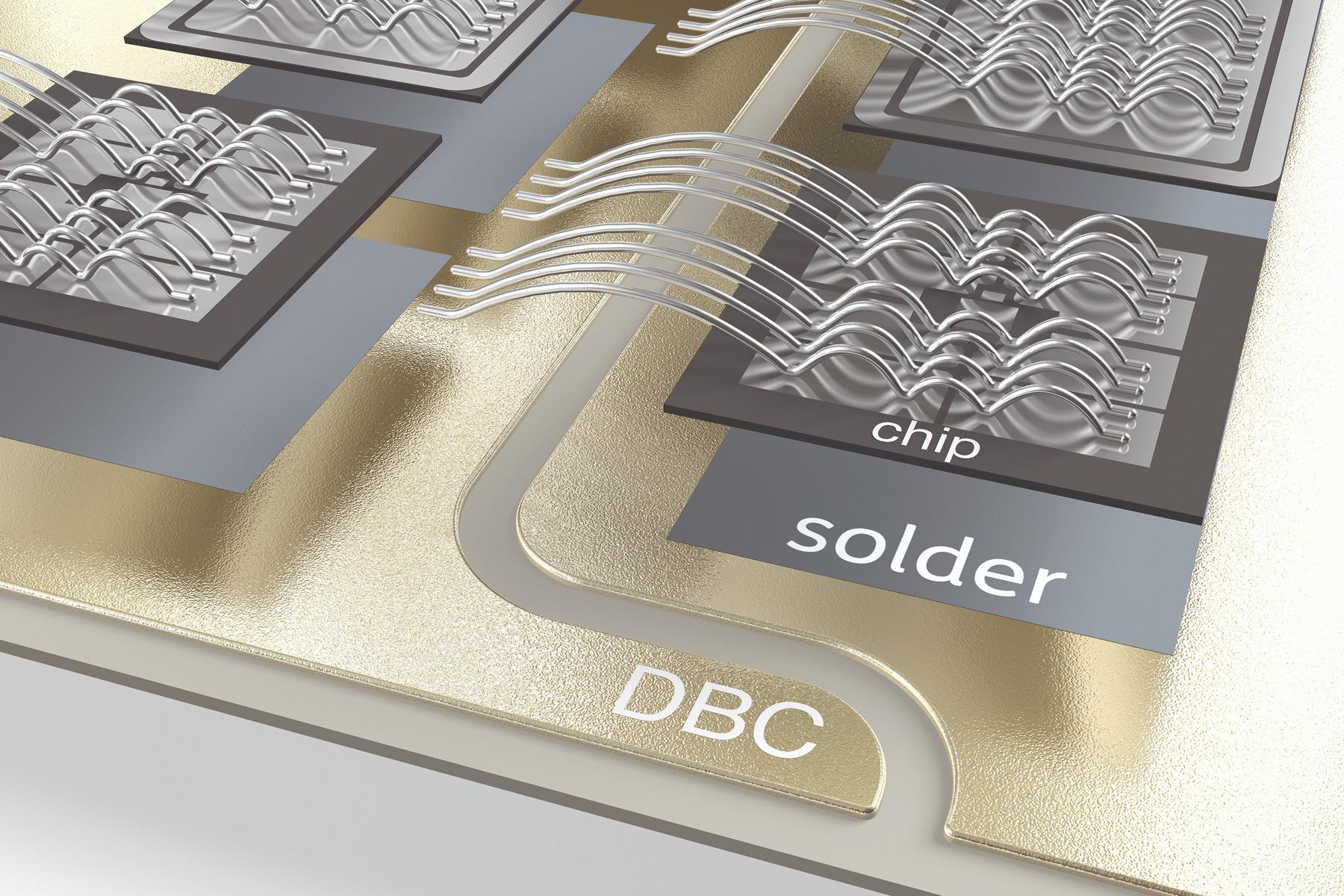
はんだは長年にわたり、チップの裏面と基板、および端子と基板の間に、信頼性の高い接合を提供してきました。はんだは、PCB コンポーネントが実装されるのとほぼ同じ方法で、ステンシルを使用して DBC 基板に塗布されます。専用のオーブンではんだを溶かし、チップに結合させます。これらのオーブンと製造プロセスの改善により、毎年生産される数百万個のモジュールにおいて、ボイドフリーのはんだ接続を実現する最新のモジュールが誕生しました。
チップ前面接続では、アルミニウムボンディングワイヤがチップ表面のアルミニウム層に超音波溶接されます。パワーサイクル摩耗メカニズムの継続的な研究により、ワイヤ直径とボンディングワイヤのアスペクト比の両方が最適化されました。これらの改善により、標準接続技術の信頼性がさらに向上し続けています。セミクロンダンフォスは、アルミニウム被覆銅ボンディングワイヤも使用しています。これらのワイヤは、銅のパワーサイクル能力を高めながら、アルミニウムボンディングワイヤのコスト効率の高い生産プロセスを維持します。
