Kontinuierliche Weiterentwicklung
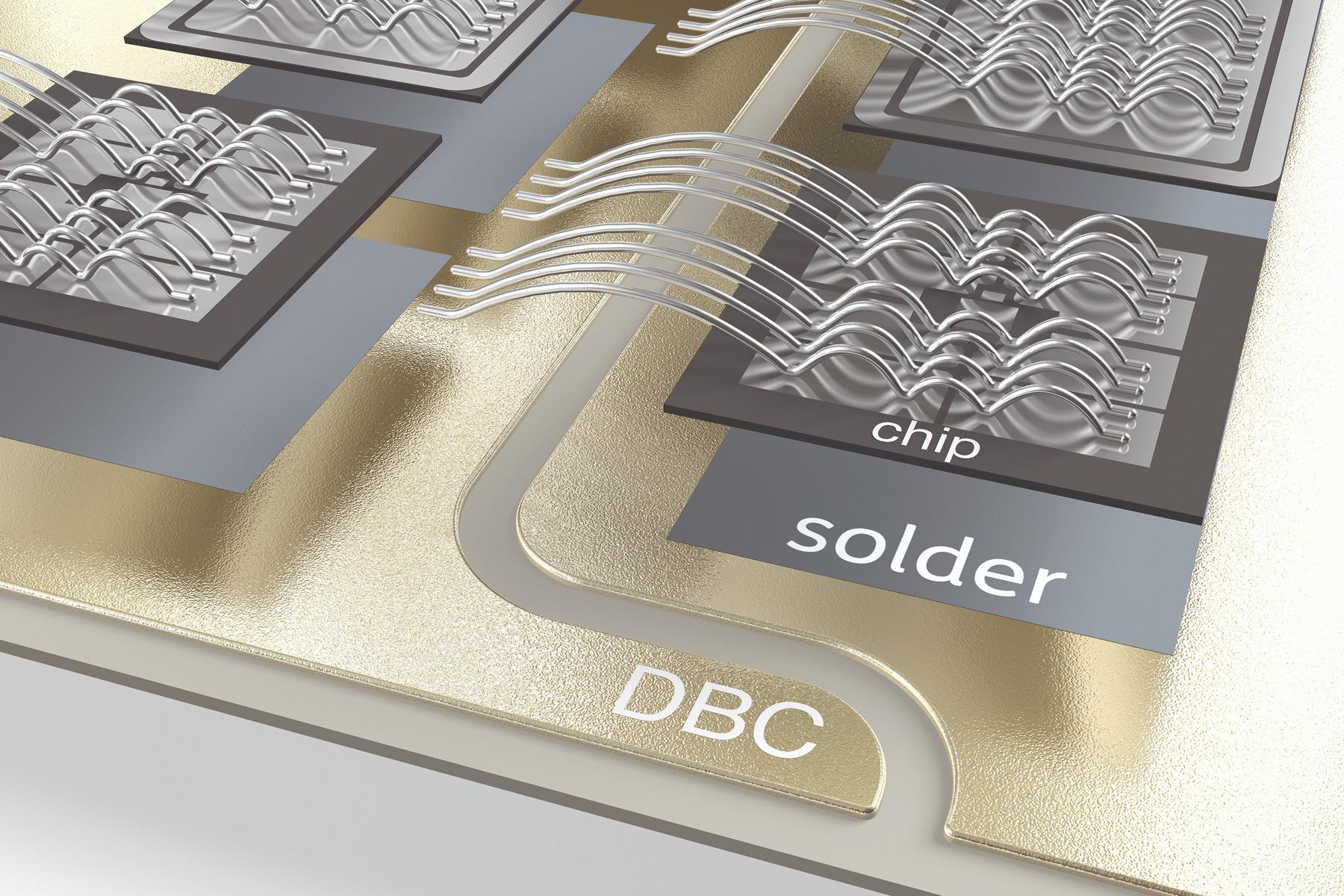
Lötverbindungen bieten seit Langem eine zuverlässige Verbindung zwischen der Chiprückseite und dem Substrat sowie zwischen Modulanschlüssen und Substrat. Lot wird mittels einer Schablone auf das Substrat (DCB) aufgetragen, sehr ähnlich dem Verfahren der Leiterplattenbestückung. Spezielle Öfen schmelzen das Lot, dass den Chip verbindet. Die Optimierung der Öfen und Verfahren ermöglicht die lunkerfreie Produktion von Millionen von Leistungsmodulen jährlich.
Für die Kontaktierung der Chipoberseite werden Aluminium-Bonddrähte mittels Ultraschall mit der Aluminiumschicht der Chipoberfläche verschweißt. Stete Forschung zu den Verschleißmechanismen durch Lastwechselbelastung hat zur Optimierung von Bonddrahtstärke und Bonddraht-Aspektverhältnis geführt. Diese Fortschritte erhöhen kontinuierlich die Zuverlässigkeit der klassischen Verbindungstechnologien. Semikron Danfoss nutzt zudem aluminiumummantelte Kupferbonddrähte. Diese vereinen die höhere Lastzyklenfestigkeit von Kupfer mit der kosteneffizienten Verarbeitung von Aluminumbonds.
